
【IC风云榜候选企业63】中科智芯:深耕晶圆级先进封装力争特色封装重要一席之地
发布时间:2024-02-04 02:03 | 作者: 火狐体育葡萄牙官方合作
【编者按】2024年度IC风云榜再度升级,奖项扩展至35个、榜单增至59项,不仅在形式和深度上焕然一新,而且分类更加科学全面,产业触达程度更深、行业影响力持续扩大。本届评委会由半导体投资联盟超100家会员单位、500+半导体行业CEO共同担任,获奖名单将于2024半导体投资年会暨IC风云榜颁奖典礼上隆重揭晓,激发产业创新潜能,树立产业新标杆。


集微网消息,“后摩尔时代”制程技术突破难度较大,工艺制程受成本大幅度增长和技术壁垒等因素上升改进速度放缓。为了在更小的封装面积上容纳更多引脚,先进封装向晶圆制程领域发展,直接在晶圆上实施封装工艺,通过晶圆重构技术在晶圆上完成晶圆重构、重布线、凸点等工艺形成与外部互联。提升产品功能同时又减少相关成本,是后摩尔时代的主流发展方向。
晶圆级先进封装技术的应用十分普遍,极大的满足于便携式电子设备、智能手机、平板电脑、可穿戴设备等小型高集成度产品的需求。
江苏中科智芯集成科技有限公司便是一家聚焦于晶圆级先进封装技术开发与产业化的企业,于2018年3月22日在江苏徐州经济技术开发区注册成立,参与投资建设的股东包括中科院微电子所、华进半导体、徐州中科芯韵、金浦集团、新潮集团、TCL创投、恒兴集团、浑璞投资、新鼎资本等,目前注册投资的金额为24028.59万元,项目目前总投入6.7亿元(不含厂房)。

目前,国内具备晶圆级先进封装能力的代工厂屈指可数,按照先进封装类型可分为晶圆级凸点封装、扇入封装、扇出封装、2.5D/3D封装等。其中,扇出封装工艺为中科智芯主要特色产品,良率已达98.5%以上,且产品成本低、工艺成熟。
中科智芯主要营业产品涵盖8/12英寸晶圆薄芯片制备(DPS)、凸点(微凸点)、芯片规模封装(WLCSP)、扇出型封装(FOWLP)、扇出系统集成封装(FO-SIP)、三维堆叠封装(3D Stacking)等,包含研发打样、新产品研究开发、替代产品验证等多种形式。
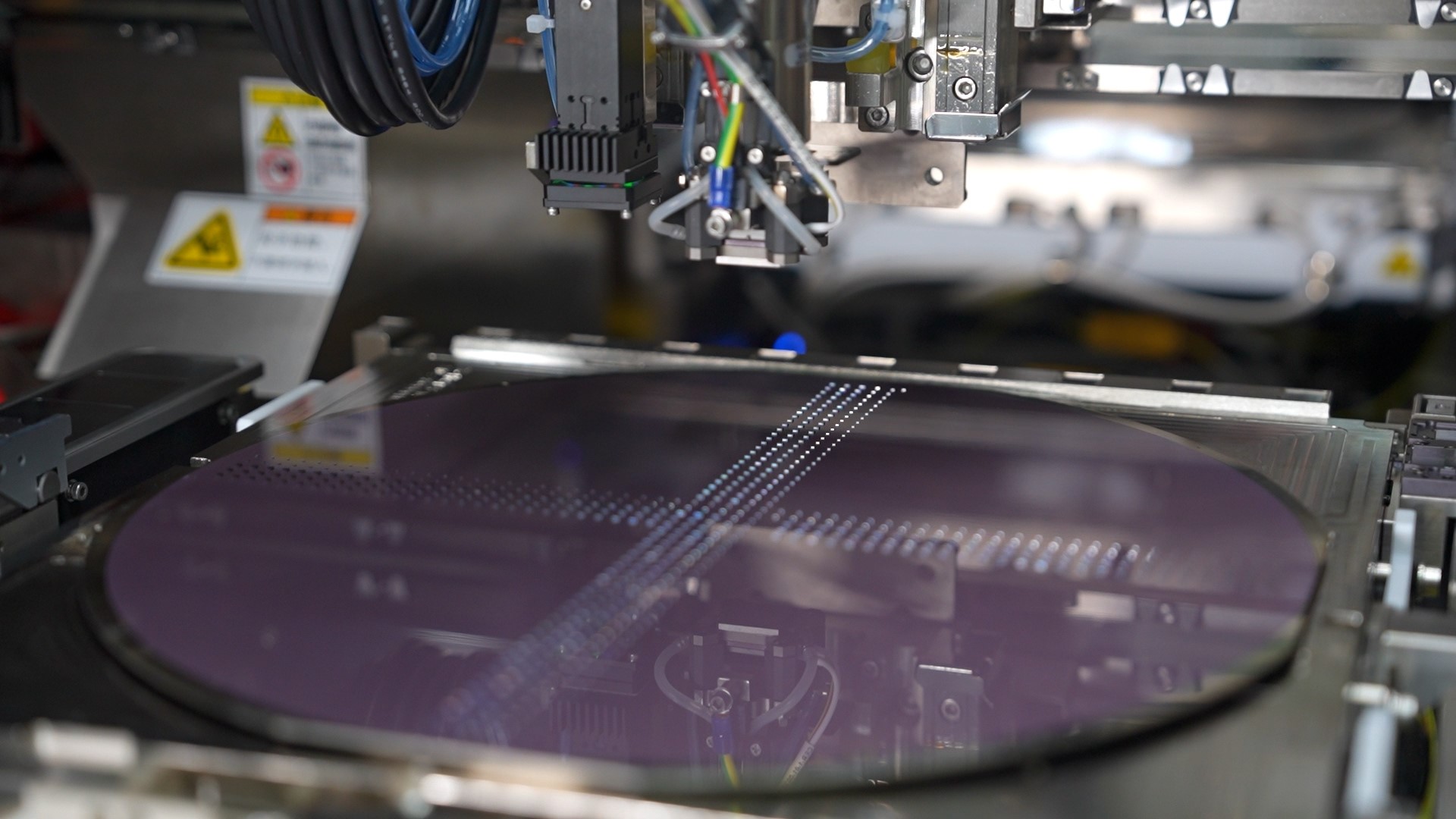
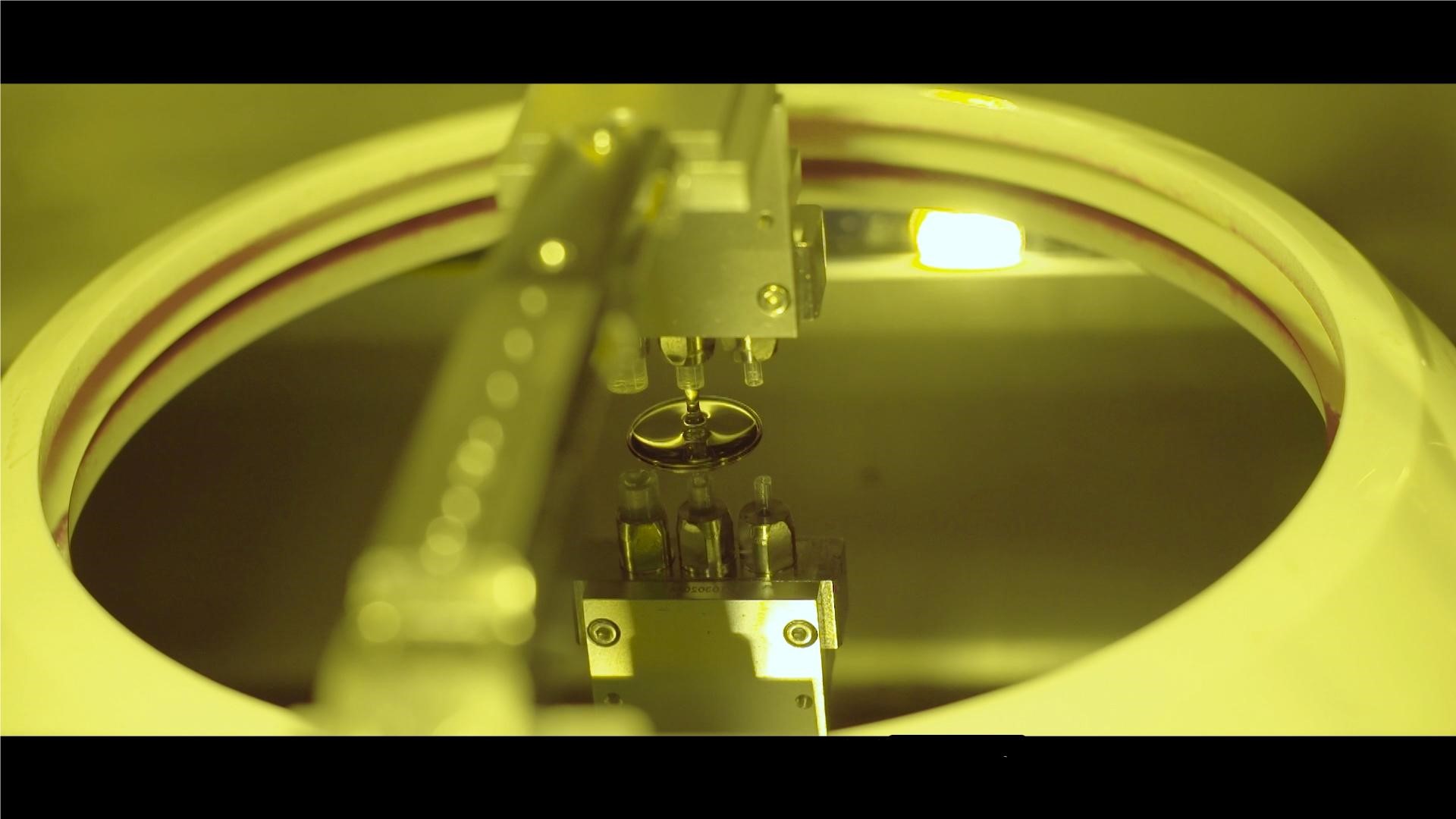
中科智芯作为2019年江苏省级重大产业项目,于2019年11月进驻新建101厂房,2021年经公司股东会批准通过了一期扩产规划,建设102厂。补充了包括DPS、测试、研发实验室等净化车间,达成晶圆级中后道封装配套生产能力,实现产能月产大于三万片晶圆的封测能力。
中科智芯的晶圆级先进封装技术主要涵盖四大关键技术及创新点:重构晶圆的芯片偏移、矫正与补偿;减小介电材料带来重构晶圆翘曲;实现重布线层与层、芯片之间高精度对位;量产中扇出封装产品良率的稳定性。目前,中科智芯累计拥有有效专利31件(发明专利20件,实用新型11件),申请中的发明专利有18项。
中科智芯2019年通过科技部重大专项课题答辩,目前在研承担国家攻关工程、国家级外专项目、徐州市重点研发专项等国市级研发项目,通过徐州市工程技术研究中心、企业技术中心认证。此外,还荣获国家高新技术企业、江苏省民营科技公司、江苏省半导体协会理事单位、江苏省集成电路先进封装技术创新联合体成员等多项荣誉称号。
中科智芯表示,未来将继续致力于各种先进封装技术创新,以客户的真实需求为发展趋势与驱动力,在特色封装技术和产业高质量发展上在国内占有重要一席之地。
2024半导体投资年会暨IC风云榜颁奖典礼将于2023年12月举办,奖项申报已启动,目前征集与候选企业/机构报道正在进行,欢迎报名参与,共赴行业盛宴!
旨在表彰2023年度实现单款产品高出售的收益或销量收入突出性高增长,在细致划分领域市场占有率处于领头羊,产品应用市场广泛的企业。
1、深耕半导体某一细致划分领域,2023年企业总体营收超过1亿元人民币,或实现20%以上的增长;2、产品具备较强市场竞争力,在细致划分领域占据领先的市场占有率,具有完全自主知识产权。
1、技术或产品的主要性能和指标(30%)2、产品的销量及市场占有率(40%)3、企业营收情况(30%)
大众聚鼎荣获IC风云榜“年度最佳新锐投资机构奖”&“年度中国半导体投资机构Top100”
集微咨询发布“2023年中国半导体融资规模TOP20” 单笔融资最低5亿元
高云半导体荣获“2024年IC风云榜——年度智能汽车产业链最受机构关注奖”
东软睿驰与国芯科技达成战略合作,共同打造具有竞争力的智能网联汽车技术解决方案
发力Wi-Fi 7无线通信芯片!东芯股份拟对外投资2900万元设立子公司